原子力显微镜-红外光谱(AFM-IR)对纳米尺度缺陷与残留物的化学分析
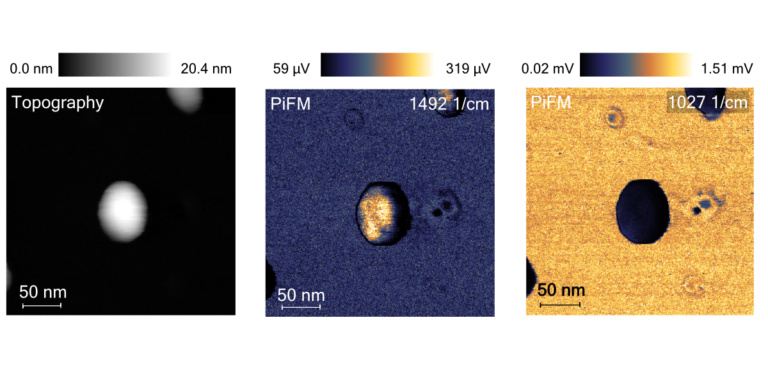
Get the pdf download to your inbox:
背景
在许多制造流程中,缺陷管控至关重要。缺陷会导致产品良率下降、成品可靠性降低乃至功能失效。缺陷可能源自外来污染物引入、材料去除不彻底(产生残留)、组成材料或清洁剂的意外反应,以及由热/湿气/光线等外部因素引发的缓慢化学变化。所有这些情形中,缺陷的化学构成都是关键信息,能为制造工程师追溯缺陷根源提供依据。
现有分析技术
多数分析实验室配备的元素分析技术(如能量色散X射线光谱EDX、全反射X射线荧光TXRF、具有纳米级空间分辨率的俄歇电子能谱)可满足先进制造对缺陷元素信息的常规需求。虽然这些技术能有效识别金属及部分无机材料,但对组成元素相同的有机/无机材料鉴别力不足,因其无法提供化学键信息。
分子信息分析则主要依靠傅里叶变换红外光谱(FTIR),但其空间分辨率过低(>10µm),故常需结合拉曼光谱、飞行时间二次离子质谱(TOF-SIMS)和X射线光电子能谱(XPS)等技术。其中TOF-SIMS具有最高标称空间分辨率(约200nm)和低检测限优势,但存在样品破坏性、真空兼容性要求高及分析复杂等局限。
鉴于当前缺陷分析仪器体系的现状,当缺陷横向尺寸小于1微米时,联合使用多种技术”推测”缺陷分子性质已成为常态;若缺陷厚度极薄(<100nm),因部分技术在此尺度信噪比恶化,分析难度将进一步加剧。
光诱导力显微镜技术
IR PiFM凭借其卓越的空间分辨率与灵敏度,非常适用于纳米尺度缺陷与残留物的分子分析。相较于前述多技术联用的推测性分析,PiFM常能基于成熟的FTIR光谱库对缺陷进行明确鉴定。尽管PiF-IR光谱采集自约10纳米区域,其与体相FTIR光谱高度吻合,可精准识别小至10纳米的缺陷。
Get the pdf download to your inbox:
采用光诱导力显微镜(PiFM)的纳米颗粒缺陷分析
图1展示了在20纳米聚苯乙烯(PS)纳米颗粒及云母基底上采集的PiF-IR光谱,并附二者对应的体相FTIR参考光谱。插图分别显示1492 cm⁻¹与1025 cm⁻¹波数处的形貌图与PiFM图像,以突出PS颗粒与云母基底。形貌图清晰显示颗粒高度约20纳米(参见图像上方对比标尺),横向尺寸约50纳米——该尺寸扩张源于探针针尖曲率半径的卷积效应(因金属涂层处理,曲率半径典型值约为30纳米)。1100至1360 cm⁻¹区间出现的额外光谱特征可能源于与PS颗粒共沉积的液相分子(如表面活性剂)。

图2展示基于PiF-IR光谱鉴定硅晶圆表面未知缺陷的典型案例。图2a显示缺陷尺寸约100纳米,厚度约3纳米。基底光谱在1090 cm⁻¹附近呈现本征氧化硅的典型特征峰,而缺陷光谱与聚四氟乙烯(Teflon)的FTIR光谱高度吻合,表明该纳米缺陷为类聚四氟乙烯材料。图2b呈现高度约15纳米、尺寸约50纳米的缺陷。结合探针曲率半径判断,该缺陷应为直径约15纳米的球形颗粒。基底与颗粒的多点光谱均呈现可重复特征:硅基底以1060 cm⁻¹为中心的宽峰为特征,颗粒光谱则与二氧化硅FTIR光谱匹配。这些案例证明PiFM技术可同等高效地识别有机与无机纳米材料。

残留物分析的PiFM应用
残留物是另一种常见缺陷类型。当残留物呈超薄形态时,现有显微或光谱技术极难检测其存在。图3展示键合垫上残留物的典型案例,该残留导致键合界面与配对部件粘附异常。PiF-IR光谱清晰揭示了该残留物作为加工工序副产物的化学特征。图3a显示键合垫形貌,3b则呈现与残留缺陷特征吸收波数对应的PiFM图像。
在PiFM成像中,信号强度与吸收强度直接相关。因此图3b中金色区域即为残留物分布区。由于形貌图未显示与残留物相关的特征结构(仅呈现键合垫金属颗粒的晶粒结构),可推断该残留物厚度至多为数纳米。本例中 intentionally 未具体说明金属垫与残留物的化学属性。

总结
综上所述,IR PiFM是一种强大的分子分析工具,即使对于尺寸小至约10纳米且呈超薄形态的未知缺陷与残留物,也能实现精准分析。当缺陷尺寸过小或过薄,导致TOF-SIMS、XPS、FTIR、拉曼光谱及SEM/EDS等现有技术无法有效检测时,IR PiFM能够提供关键化学信息,揭示缺陷的本质特性。
| 红外光诱导力显微镜(IR PiFM) | 拉曼光谱仪(Raman) | 傅里叶变换红外光谱仪(FTIR) | 飞行时间二次离子质谱仪(TOF-SIMS) | X射线光电子能谱仪(XPS) | 全反射X射线荧光光谱仪(TXRF) | 扫描电子显微镜/能量色散X射线光谱仪(SEM/EDS) | 透射电子显微镜(TEM) | 俄歇电子能谱仪(Auger) | |
| 检测项目 | 分子成像(M.I.) | 分子成像(M.I.) | 分子成像(M.I.) | 分子成像(M.I.) | 分子成像(M.I.) | 元素成像(E.I.) | 元素成像(E.I.) | 元素成像(E.I.) | 元素成像(E.I.) |
| 化学成 分分布成像 | 支持 | 支持 | 支持 | 支持 | 支持 | 支持 | 支持 | 支持 | 支持 |
| 横向分辨率 | ~5 nm | > 0.5 µm | > 10 µm | > 0.2 µm | 10 µm – 2 mm | ~10 mm | 1 nm * 0.5 µm EDS | 0.2 nm | > 10 nm |
| 探测 深度 | 20 nm & 体相 | > 500 nm | 1 µm | 1 nm | 10 nm | 10 nm | 1 µm | ~100 nm | 10 nm |
表1. 红外光诱导力显微镜(IR PiFM)将分子层面分析推进至真正纳米级分辨率领域,可同步提供~5 nm空间分辨率的红外吸收光谱与化学成分分布成像,并具备单分子层检测灵敏度。
Interested in a niche application?
Ask us, we may have already studied it.