原子级加工
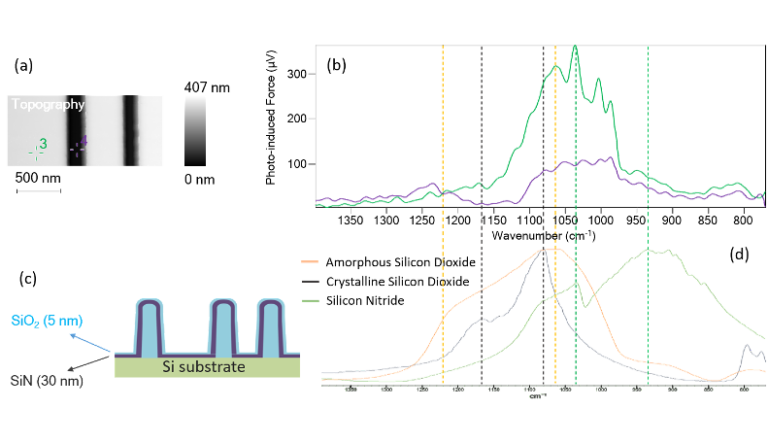
Get the pdf download to your inbox:
随着集成电路器件持续微型化,表面层已成为器件尺寸的重要组成部分,实质性影响器件性能。为在原子层面管控表面质量,需对原子级加工工艺进行有效表征。光诱导力显微镜(PiFM)凭借其检测有机/无机介电质原子层尺度厚度的能力,以及与该类器件相关的空间分辨率(约5纳米),成为表征原子级加工过程的理想技术。本应用说明通过PiFM分析了有机分子自组装单分子层(SAM)的形成过程,该技术被广泛应用于区域选择性沉积(ASD)工艺中的阻挡层。
图1c与1d分别展示了参考样品的结构及从spectrabase.com获取的SiN与SiO₂的FTIR光谱。样品为硅基底上制备的SiO₂线性光栅结构(具可变宽度与间距),表面覆有30纳米SiN与5纳米SiO₂覆盖层。在形成十八烷基三氯硅烷(ODTS)自组装单分子层前,样品经历了未公开序列的退火与清洗工艺。本次测量旨在探究自组装单分子层分子堆积密度在平坦与弯曲表面的差异。图1a与1b分别展示了带位置标记的样品形貌图及各标记点采集的PiF-IR光谱。尽管顶部SiO₂层仅5纳米厚,但上部(位置3,绿色)与下部(位置4,紫色)区域的PiF-IR光谱均清晰显示出SiO₂与SiN的红外吸收峰;由于PiFM可探测至表面下约20-30纳米深度,因此成功检测到SiN特征信号。有趣的是,上下表面氧化物的化学性质存在差异,很可能源于所述退火与清洗工艺:上部表面光谱呈现晶态SiO₂特征,而下部表面则显示非晶态SiO₂特性。鉴于样品经历的退火与清洗工艺细节未知,难以更确切解释光谱差异的起源。尽管如此,PiFM能从5纳米厚SiO₂的受限空间中揭示化学差异这一事实,充分证明了其在原子层沉积工艺表征中的应用潜力。

接下来对覆有ODTS自组装单分子层(SAM)的样品进行分析,结果如图2与图3所示。图2a展示了光栅上下表面与SiO₂相关的PiF-IR特征峰,以及叠加在三维形貌上的1095 cm⁻¹波数光诱导力(PiF)强度分布。插图中显示形貌图及跨结构采集的18组光谱位置标记。上下表面的光谱特征与图1参考样品观测结果相似:上表面在1000-1100 cm⁻¹区间信号显著更强,下表面则在1240 cm⁻¹附近出现特征峰且1000-1100 cm⁻¹区间信号减弱。由于SAM层极薄,我们可对SAM层下方的SiO₂层进行分析。

图2b展示了线性光栅结构上下表面ODTS自组装单分子层(SAM)的C-H伸缩振动模式,以及叠加在三维形貌上的2921 cm⁻¹波数PiFM信号强度分布。上下表面光谱均呈现良好重复性,其中下表面在2921 cm⁻¹处的特征峰强度显著更高——该现象在三维PiF/形貌图像中清晰可见,表明下表面具有更高的分子堆积密度。尽管仍难以解释不同表面SiO₂层化学差异的本质,我们将SAM堆积密度的差异归因于上下表面硅氧化物化学性质的不同。

本实验旨在探究表面曲率对自组装单分子层(SAM)堆积密度的影响。图3a展示了相同位置采集的形貌图、1095 cm⁻¹波数PiFM图像及两者的截面轮廓(基于15行数据平均生成)。观察SiO₂的PiF信号轮廓可发现,其在形貌开始滚降约60纳米后出现快速衰减。该信号减弱是由于地形陡坡导致针尖顶端与样品表面的有效相互作用区域逐渐减少。图3b展示了相同位置采集的形貌图、2921 cm⁻¹波数PiFM图像及两者的截面轮廓(15行数据平均)。在此情况下,我们观察到ODTS的C-H伸缩振动模式PiF信号恰好从形貌滚降的同一位置开始衰减。鉴于SiO₂与ODTS的测量在相同位置进行,结果确证表面曲率确实影响SAM的形成方式。

Interested in a niche application?
Ask us, we may have already studied it.